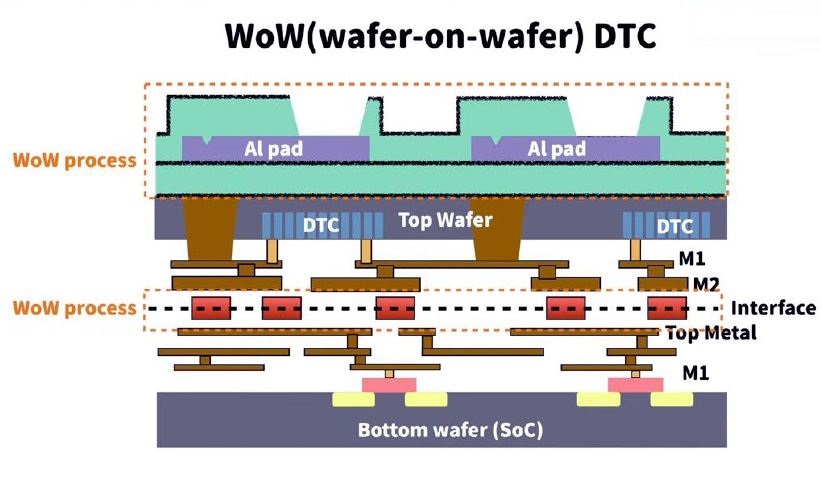
Welcome to CLISemi. This is test message!
3D封裝技術透過垂直整合多層晶片,大大提高了晶片的性能和密度。此技術可有效減少晶片之間的距離,從而顯著縮短訊號傳輸時間,適用於需要高效能和低延遲的應用場景,例如高效能運算(HPC)和人工智慧(AI)處理。
將使用更先進的晶圓堆疊技術,例如異構晶圓堆疊和晶圓到晶圓集成,以進一步提高計算效率和密度。
在整合方面,它支援將不同技術節點、不同材料甚至不同功能的晶片組合在一個封裝中,這將使設備在更有效率的空間中執行多樣化的任務,例如混合整合和應用。射頻和其他組件。
3D材料自創專利封裝材料,低成本(成本為CoWosS的1/3) 及高良率 90%以上。
材料創新是先進封裝技術進步的基礎。石墨烯、氮化鎵( GaN )、碳奈米管和超導體等新材料將用於封裝,進一步提高導熱性、導電性和可靠性。
更先進的封裝材料將支援更高頻率的應用,例如毫米波 ( mmWave ) 和太赫茲技術,這對於 5G、6G 和物聯網 (IoT) 應用至關重要。
